エッチングとは、フォトリソグラフィでパターン化されたレジストを被膜とすることで、その下の絶縁膜層などの薄膜を削るプロセスです。
最先端のナノノードの集積回路を生産するプロセスで、チップの性能を決めると言っても過言ではないほど重要です。
エッチングプロセスでは、実際に集積回路のパターンとなる基礎を形成しますので、他のプロセス装置と比べて精密な技術と調整が求められます。
それでは今回は、エッチングプロセスの原理や重要なパラメータに関してご紹介していきます!
ドライエッチングのプロセスとは?
今回紹介するエッチングの方法は『ドライエッチング』についてです。
エッチングには大きく分けて2種類方法があり、以下の通りです。
- ドライエッチング:プラズマやラジカルを薄膜に照射することで蝕刻する。
- ウェットエッチング:フッ素などの腐食液をウエハに漬けることで溶解する。
ウェットエッチングについて詳しくは、こちらを参考にしてください!
今回は、薬液を使った『ウェットエッチング』の基本原理とエッチング中に注意しなければならないポイントに重点を置いて説明します。半導体チップには性能によって様々な金属膜や、化学薄膜、ウエハの材料などが異なるため、同じエッチング溶液だけ[…]
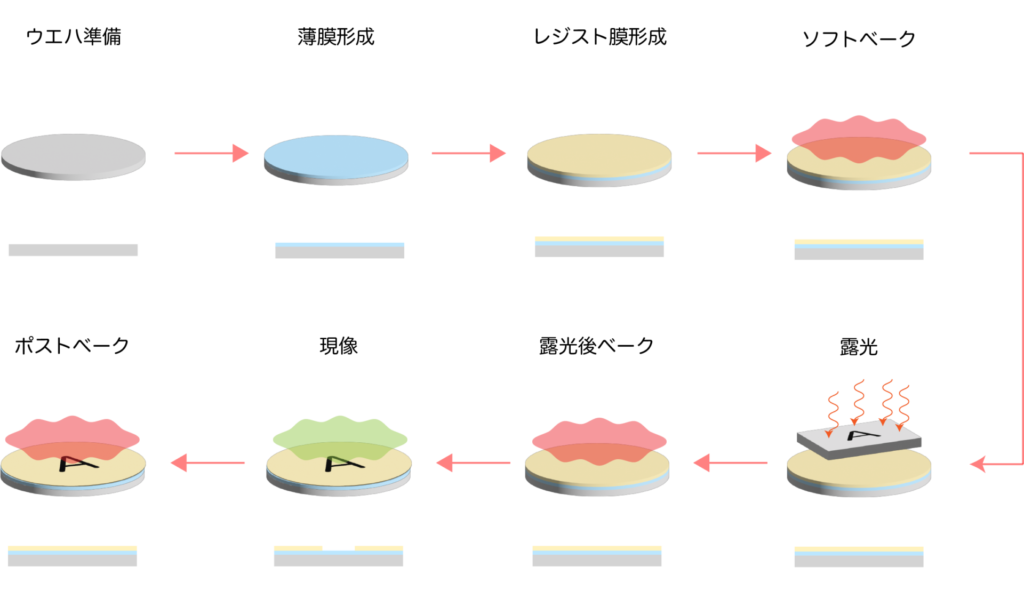
まずエッチングが行われるのは、フォトリソグラフィー工程の後になります。
フォトリソグラフィの工程で、レジストが回路パターンを形成するように露光が行われます。
その後にエッチング装置にウエハが搬送され、エッチング処理をすることになります。
フォトリソ工程について詳しくは、こちらを参考にしてください!

これは大体の半導体チップ(CMOS)のフォトリソ後の断面図です。
この状態でエッチング装置に搬送されてきます。
エッチング装置にウエハが置かれた後に、チャンバー内を真空にします。
ある程度、低真空になった後は、エッチング(蝕刻)の対象となる材料に反応する気体を充填します。
その後に、RF電源(高周波数電源)をオンすることによって、チャンバー内に設置された上下の電極から電荷が飛び出します。
その電荷が、チャンバー内の気体とぶつかる事で、イオン化やプラズマ化することで、ウエハに衝突します。
衝突したイオンやプラズマが、エッチングする対象の膜と化学反応をする事で、蝕刻されるというメカニズムです。

この際にレジストパターンはエッチングに反応しませんので、蝕刻されることはありません。
ですので、レジストパターンがないところの被エッチング膜が蝕刻されます。
露光機のマスクの原理について詳しくは、こちらを参考にしてください!
ほとんどのプロセスでは、レジストを被膜として使用されています。
ハードマスクエッチングとは?
レジストを使用しない方法もあり『ハードマスク』と呼ばれる、パターン状の基盤に回路が描かれているものを使用することもあります。
このハードマスクをウエハと電極の間に差し込むことで、イオンやプラズマの流れをコントロールする事で、マスクと同じ形状に薄膜をドライエッチングすることができます。

ドライエッチングの重要パラメータとは?
ドライエッチングプロセスもかなり高度な制御が求められます。
例えば目に見えないナノレベルのプラズマを使用しますし、エッチングに求められる幅や深さの均一性も重要です。
このような条件をクリアするための重要なパラメータは以下の通りです。
- 反応ガスの種類・構成比
- ステージ温度
- 真空チャンバー圧力
- RF電源の出力・電極均一性
- チャンバー構造
- チャンバー内の気体の流れ
ドライエッチングの指標とは?
エッチング選択比
エッチングで重要な指標といえば『エッチング選択比』です。
プラズマやイオンで薄膜をエッチングする際には、必ずウエハ上の被エッチング膜が均等に蝕刻されなければいけません。
レジストは被膜として、下の薄膜をエッチングから守る役割がありますが、必ずしもレジストがエッチングされないとも限りません!

高エネルギーのイオンがレジストに衝突した際に、少しは削れてしまいます。
ですのでレジストが削られて薄膜に到達する前に、ウエハ全体の被エッチング膜を蝕刻する必要があります。
この『レジストのエッチングスピード』と『被エッチング膜のエッチングスピード』の比のことを『エッチング選択比』と言います。
その
またレジストだけではなく、ウエハのエッチングスピードも考慮する必要があります。
ウエハのエッチングスピード

エッチングで最も重要なことは『エッチング選択比』もそうですが、ウエハ全体が均一にエッチングされることも重要です。
例えばウエハの中央のエッチングが早く、外側が遅い場合、外側のエッチングが完成するのを待っていると、中央がどんどんエッチングされ、ウエハがまで到達してしまいます。
このことを『オーバーエッチング』といい、ウエハまで削られてしまうと重大なプロセス異常になります。

エッチングの偏差とは?
エッチングはレジストを被膜として、回路パターンを形成すると冒頭でも紹介しました。
言い方を変えれば、レジストパターン以外のところはエッチングされてはいけません。
ですので、レジストのパターン通りにエッチングされることが大前提として重要です。
もしレジスト被膜の部分もエッチングしてしまうことを『エッチング偏差』と言います。

等方性と異方性エッチングの違いとは?
薄膜をエッチングする種類には大きく分けて2つあります。
- 等方性エッチング:どの方向からも被エッチング膜がエッチングされること。
- 異方性エッチング:一方向からのみ被エッチング膜がエッチングされること。

今回紹介したドライエッチングには『異方性エッチング』が一般的に使用されています。
異方性エッチングは一方向のみドライエッチングされますので、微細なノードの集積回路の生産に使用されます。
等方性エッチングは、半導体層のパターンに特徴のある際に使用されます。
先ほど紹介したオーバーエッチングに似ており、意図的にレジスト被膜の下までエッチングし、エッチング偏差を出すことを目的としています。
エッチングについて詳しくは、こちらも参考にしてください!









