リソグラフィ装置(露光機)で使用されるフォトマスクは、半導体チップ(IC)の回路パターンとなる『原版・原画』です!
露光機から照射される光が、マスクのパターンに沿ってウエハ上に塗布されたレジストに届き、レジストが化学反応することで回路パターンを形成することができます。

フォトマスクが『原版』といっても、製造される半導体チップによって様々あり、各プロセスによってもマスクの形状は異なります。
一般的に使用されているフォトマスクのサイズは『6×6インチ(15cm×15cm)』で、石英またはガラス基板で出来ています。
フォトマスクは不透明なフィルムでコーティングされており、精密な微細ノードのフォトマスクは他の材料が使用されていることがあります。
またフォトマスクと呼ばれるものとレチクルと呼ばれるものがありますが、違いは以下の通りです。
- フォトマスク(Photo Mask):1×ステッパーまたはフォトリソグラフィー全般で使用される『原版・原画』
- レチクル(Reticle):2×、4×、5× 縮小ステッパーで使用される『原版・原画』
リソグラフィ装置(露光機)について詳しくは、こちらを参考にしてください!
フォトマスクの使用プロセスとは?
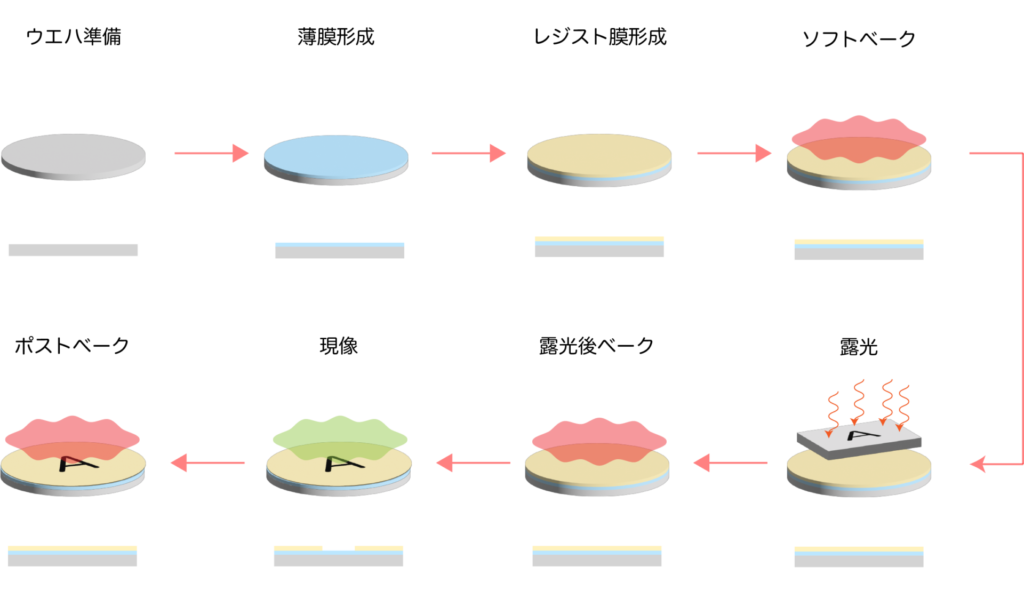
半導体製造プロセスの基礎工程として、半導体メーカーがまず製造する半導体チップ(IC)を設計します。
その設計に沿うように光を照射するためのフォトマスクが製作され、リソグラフィー装置に取り付けられます。
リソグラフィ機(露光機)は、フォトリソ工程に属しており、レジストが塗布されたウエハ上に、光をフォトマスクを通して照射することによって、レジスト上に回路パターンを転写します。
フォトリソ工程について詳しくは、こちらを参考にしてください!
フォトマスクの製造とは?
設計と準備
まず、製造される半導体チップの回路に従ってマスクレイアウトを作成する必要があります。
このプロセスは通常、コンピュータ支援設計 (CAD) ソフトウェアを使用して実行されます。
設計が完了すると、マスクパターンのデータファイルが出来上がります。
フォトマスク基板の選択

適切な基板材料を選択することは、フォトマスクを作成する際の重要な部分です。
一般的に使用される基板材料は『石英またはガラス』です。
フォトマスクは強いエネルギーの光を長時間照射されますので、高い透明性、低い膨張係数、高い引張強度などの特性を備えている必要があります。
基板の洗浄
マスクを作成する前に、マスクの元となる基板をキレイに洗浄する必要があります。
この洗浄プロセスでは溶剤、酸、超音波、またはジェット洗浄を使用して、表面から塵や不純物を除去することが目的です。
遮蔽膜の形成

遮蔽膜はガラスなどのフォトマスクの元となる基板の上に堆積される薄い膜のことです。
この遮蔽膜が光を遮るエリアと透過するエリアに分かれることによって、回路パターンをレジスト上に転写することができます。
遮蔽膜の形成プロセスとして、主にPVD法のスパッタリングや蒸着法よって形成されます。

PVDについて詳しくは、こちらを参考にしてください!
このPVD法で基板上に堆積される遮蔽物は、『クロム系の金属』が使用されています。
なぜクロム系の金属を使用しているかは、以下の理由の通りです。
- 遮光膜(クロム膜)のメカ的な強度がある
- クロム膜形成を薄くすることができる
- 投影フリンジがない為、微細なパターンを転写することができる
- マスク内の熱滞留が少ない
フォトレジストを塗布

遮蔽膜を形成した基板上に、フォトレジストの層をコーティングします。
フォトレジストは、光にさらされると化学変化を起こして所望のパターンを形成する感光性材料です。
レジストについて詳しくは、こちらを参考にしてください!
フォトレジストは、フォトリソグラフィの核の技術でもあり、欠かせない材料です。レジストは、フォトリソグラフィ工程で、ウエハ表面に塗布され、ソフトベーク(加熱)、露光、エッチング、レジスト除去プロセスまで続く長いプロセスに関係がありま[…]
リソグラフィ(露光)

設計したマスクパターンのデータファイルを用いて、電子ビームや露光機などでレジストに光を照射します。
この電子ビームは1本の光ではなく、一度に数万という光を照射することができ、微細なマスクパターンであっても高速且つ精密に描画することができます。
露光プロセス中に、光または電子ビームの照射によりフォトレジスト内の感光性分子が変化します。
- ポジ型レジスト:露光後に露光部分の接着剤状ポリマーが光溶解により破壊して軟化し、最終的には現像液によって溶解されます。
- ネガ型レジスト:露光後に露光部分が硬化して残り、未露光の部分は現像液によって溶解されます。
デベロッパー(現像)

電子ビームでの露光後、フォトレジストの架橋していない部分を除去するために基板を現像液で洗う必要があります。
現像プロセスの後、マスクパターンと一致するフォトレジストパターンが基板上に形成されます。
デベロッパー(現像)について詳しくは、こちらを参考にしてください!
レジストと遮蔽膜をエッチング

ウェットエッチングやドライエッチングなどのプロセスを使用して、フォトレジストで覆われていない基板の部分を除去します。
このようにして、マスクパターンに一致する遮蔽膜が基板上に形成されます。
エッチングについて詳しくは、こちらを参考にしてください!
フォトレジストの除去

溶剤またはその他の方法を使用して基板上に残っているフォトレジストを除去し、エッチングされた溝パターンを露出させます。
レジストを除去するプロセスを『アッシング(灰化)』と言い、ドライアッシングとウェットアッシングに分別されます。
主には酸素プラズマやオゾンプラズマをレジストに当てることによって、レジストが酸素分子と結合し、気化することで除去することができます。
プラズマについて詳しくは、こちらを参考にしてください!
フォトリソ工程をシリコンウエハが通過した後に行われるプロセスが『エッチング』と呼ばれるプロセスです。エッチングでは、フォトレジストを被膜としてフォトレジストがない部分の絶縁体(薄膜)を除去するプロセスです。ここではドライエ[…]
検査と修復

完成したマスクは、パターンが設計と一致し、欠陥がないことを確認するために検査されます。
欠陥がある場合は、フォトリソ工程をやり直すことで修復することができます。
各プロセスでのフォトマスクの使用

一般的な集積回路製造プロセスには、アクティブエリア、コンタクトホール、金属相互接続線、絶縁層などの異なるプロセスステップに対応する、数十枚の異なるマスクが使用されます。
各マスクごとに異なるパターンが含まれており、そのプロセスに合ったパターンをシリコンウエハ上に転写するために使用されます。
製造プロセス中、個々のマスクが特定の順序で使用され、集積回路の構造が層ごとに構築されます。
各マスクには特定の役割があるため、最終的な集積回路が設計仕様を確実に満たすためには、マスクセット内のすべてのマスクが正確に一致する必要があります。

製造される半導体デバイスに応じて、各リソグラフィー装置には「マスクセット」と呼ばれる5~40 の個別のフォトマスクが必要になる場合があります。
ちなみに10nm光学マスクには76個の個別レチクルが必要で、28nmノードにはレチクルが約46個が必要になります。
フォトマスクの原理とは?

現在の光リソグラフィーシステムは、異なる波長の光源を組み合わせています。
現在、最も一般的なリソグラフィー(露光)は、248nm と 193nm の波長の光源を使用しています。
- G線(436nm) レジスト線幅0.89um 1982年量産開始
- I線(365nm) レジスト線幅0.37um 1994年量産開始
- KrF(248nm) レジスト線幅0.25um 1999年量産開始
- ArF(193nm) レジスト線幅65nm 2005年量産開始
- F2(157nm) レジスト線幅32nm 2009年量産開始
- EUV(13nm) レジスト線幅10nm 2016年量産開始
最先端のリソグラフィ装置については、こちらを参考にしてください!
フォトリソグラフィのマスクは、ガラス基板上の不透明なクロム層(遮蔽膜)で構成されます。
フォトマスクの製造業者は、選択した位置のクロムをエッチングして、ガラス基板を露出させます。
他にエッチングされたクロム膜が無いため、照射した光はマスクに当たり、ガラス領域を通過し、レジストを露光します。
クロム膜部分は『光遮断効果』により、光はクロム部分を通過しません。











